科技工作者之家
加好友
科技工作者之家 2021-09-15
近日,中国科学院微电子研究所集成电路先导工艺研发中心在极紫外光刻基板缺陷补偿方面取得进展。 与采用波193nm的深紫外(DUV)光刻使用的掩模不同,极紫外(EUV)光刻的掩模采用反射式设计,其结构由大约40层Mo和Si组成的多层膜构成。在浸没式光刻技术的技术节点上,基板制造和掩模制造已足够成熟,掩模缺陷的密度和尺寸都在可接受的水平。但是在EUV光刻系统中,由于反射率及掩模阴影效应的限制,掩模基板缺陷是影响光刻成像质量、进而导致良率损失的重要因素之一。
基于以上问题,微电子所研究员韦亚一课题组与北京理工大学教授马旭课题组合作,提出了一种基于遗传算法的改进型掩模吸收层图形的优化算法。该算法采用基于光刻图像归一化对数斜率和图形边缘误差为基础的评价函数,采用自适应编码和逐次逼近的修正策略,获得了更高的修正效率和补偿精度。算法的有效应性通过对比不同掩模基板缺陷的矩形接触孔修正前后的光刻空间像进行了测试和评估,结果表明,该方法能有效地抑制掩模基板缺陷的影响,提高光刻成像结果的保真度,并且具有较高的收敛效率和掩模可制造性。
相关成果以Compensation of EUV lithography mask blank defect based on an advanced genetic algorithm为题发表在《光学快报》(Optics Express)上。此项研究得到国家自然科学基金、国家重点研究开发计划、北京市自然科学基金、中科院等项目资助。
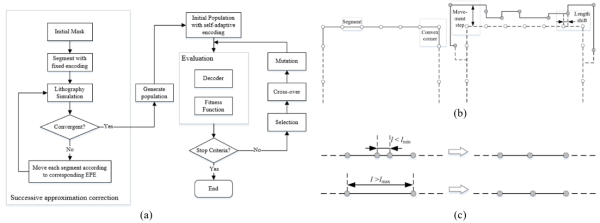
图1 (a)优化算法流程 (b)自适应分段策略样例 (c) 自适应分段的合并与分裂
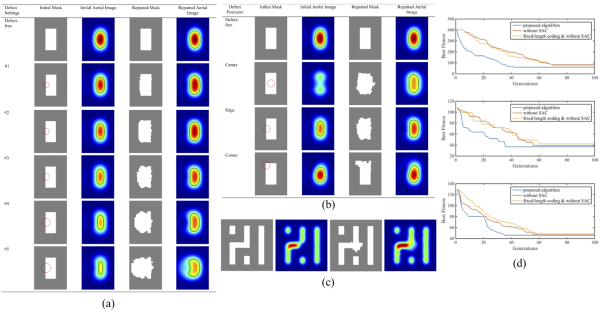
图2 (a)对不同大小的基板缺陷的补偿仿真结果 (b) 对不同位置的基板缺陷的补偿仿真结果 (c) 对复杂图形的基板缺陷的补偿仿真结果 (d) 对不同位置的基板缺陷的补偿、使用不同优化算法,目标函数收敛速度的比较
来源:中国科学院
原文链接:http://www.cas.cn/syky/202109/t20210915_4805817.shtml
版权声明:除非特别注明,本站所载内容来源于互联网、微信公众号等公开渠道,不代表本站观点,仅供参考、交流、公益传播之目的。转载的稿件版权归原作者或机构所有,如有侵权,请联系删除。
电话:(010)86409582
邮箱:kejie@scimall.org.cn

纠正算法推荐,既要听其言,更要观其行

【光刻系列讲座】 深度学习快速计算光刻技术
基板材料
极紫外光刻

环球最长水陆直线路线有多长?科学家有答案了

什么是光刻技术?
陶瓷基板
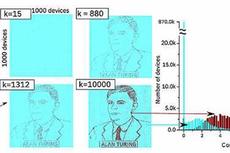
IBM研发出无监督式机器学习算法

中国首条8.5代TFT-LCD玻璃基板生产线正式点火,实现我国高世代液晶玻璃基板“零”突破
光刻机