科技工作者之家
科技工作者之家APP是专注科技人才,知识分享与人才交流的服务平台。
科技工作者之家 2019-05-13
来源:中科院微电子研究所
近日,微电子所集成电路先导工艺研发中心,面向5纳米及以下节点高性能和低功耗晶体管性能需求,基于主流后高K金属栅(HKMG-last)三维FinFET器件集成技术,成功研制出高性能的负电容FinFET器件。
现有硅基晶体管受玻尔兹曼热力学限制,室温下亚阈值摆幅SS大于等于60mV/dec,阻碍了工作电压的继续降低。当集成电路技术进入5纳米及以下节点,随着集成度的持续增加,在维持器件性能的同时面临功耗急剧增加的严重挑战。先导中心殷华湘研究员的团队在主流后HKMG FinFET集成工艺的基础上,通过材料工艺优化和多栅器件电容匹配设计,结合高质量低界面态的3纳米铪锆金属氧化物薄膜,研制成功性能优异的NC-FinFET器件,实现了SS和阈值电压回滞分别为34.5mV/dec和9mV的500纳米栅长NC-FinFET器件,以及SS和阈值电压回滞分别为53mV/dec和40mV的20纳米栅长NC-FinFET器件。其中,500纳米栅长NC-FinFET器件的驱动电流比常规HfO2基FinFET器件(非NC-FinFET)提升了260%且电流开关比(Ion/Ioff)大于1E6,标志着微电子所在新型NC-FinFET器件的研制方面取得了重要进展。
上述最新研究结果发表在国际微电子器件领域的顶级期刊《IEEE Electron Device Letters》上(DOI: 10.1109/LED.2019.2891364),并迅速受到国际多家研发机构的高度关注。
该项集成电路先导工艺的创新研究得到国家科技重大专项02专项和国家重点研发计划等项目的资助。

图1 (a)负电容FinFET基本结构;(b-c)三维器件沟道结构与铁电HZO膜层结构;(d-e)器件I-V与SS特性;(f)最新器件性能国际综合对比(SS与回滞电压越小越好)。
来源:imecas_wx 中科院微电子研究所
原文链接:http://mp.weixin.qq.com/s?__biz=MjM5Mjk2MzU1Ng==&mid=2651729535&idx=1&sn=9c8d7e75abe41a3ea6b213ff42314548&chksm=bd64c0f48a1349e255e54ffce0d08110ad08eb46f474a8fed043818d6ba8df869dba8f90bc0b&scene=27#wechat_redirect
版权声明:除非特别注明,本站所载内容来源于互联网、微信公众号等公开渠道,不代表本站观点,仅供参考、交流、公益传播之目的。转载的稿件版权归原作者或机构所有,如有侵权,请联系删除。
电话:(010)86409582
邮箱:kejie@scimall.org.cn
激光损伤阈值
生态阈值
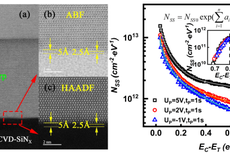
微电子所在氮化镓界面态研究方面取得进展
新技术实现微电子器件电子结构可视化

中国集成电路发展引领者黄敞逝世

微电子所在RRAM集成领域取得重要进展

写入速度比U盘快一万倍,复旦研发第三类存储技术
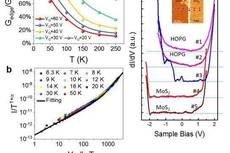
微电子所在器件物理领域取得重要进展
亚阈值电流
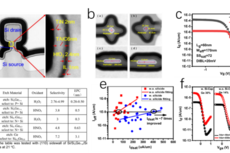
微电子所垂直纳米环栅器件研究获进展