shaolyn
加好友
shaolyn 2021-06-02
数十年来,光刻作为一种有效的图形转移技术,在实现功能性微纳米尺度结构制备方面一直扮演着重要角色,基于掩模的光刻技术在微电子工业的发展中起着不可或缺的作用。随着器件小型化和集成化,亟须发展高效、灵活的跨尺度微纳结构图案化技术。利用离子束、电子束、激光束等高能束的直写光刻技术,尽管能够实现纳米精度的图案,但是逐点扫描的方式也限制了其在制作跨尺度微纳结构时的效率。作为一种有广阔应用前景的基于数字微镜芯片(DMD)的激光无掩模光刻技术,以光学投影方式可实现大面积、多尺度结构的高效图案化,但由于受到光学衍射极限限制,线宽分辨率难以突破亚微米。
近日,中国科学院理化技术研究所仿生智能界面科学中心有机纳米光子学实验室郑研究员美玲团队联合暨南大学教授段宣明团队,在超快激光远场无掩模投影超衍射纳米光刻技术研究方面取得进展。以波长为400 nm的超快激光作为光源,利用DMD生成图案化光场,发展了无掩模光学投影超衍射纳米光刻技术,突破光学衍射极限的限制,获得了仅为激光波长十二分之一(λ/ 12)的32 nm光刻线宽,高效制备了数百微米尺度与纳米尺度并存的跨尺度微纳结构。此外,通过计算机控制更改所需的DMD生成图案化光场,便捷地实现了多种跨尺度微纳结构图案制备,简单地重复该过程,还可以实现多样化图形的批量制备。研究成果发表在Nano Letters上。
无掩模光学投影纳米光刻技术原理(图1),使用了中心波长为400 nm,重复频率为80 MHz,脉冲宽度为100 fs的飞秒脉冲激光作为光源,DMD用于光场的图案化。将带有图案信息的飞秒激光光束,通过油浸物镜聚焦到非化学放大负光致抗蚀剂(AR-N 7520)中,发生双光子聚合反应,使光刻胶固化实现图案化。研究发现,激光曝光条件对微尺度图案的成形具有重要影响,论文作者研究了微纳结构特征线宽与加工参数(激光功率、曝光时间与像素数目)之间的关系,通过对大量重复性试验数据的分析及理论建模,明确了微结构特征线宽与加工参数之间的规律,实现了不同特征线宽的可控曝光。在单脉冲功率密度1.40×105 W/cm2、曝光时间为1.5 s的条件下,由单像素组成的线阵列可获得32 nm线宽的超衍射聚合物线;在单脉冲功率密度3.65×105 W/cm2 、曝光时间为0.6 s时,2×2像素可获得66 nm的超衍射聚合物点(图2)。通过DMD控制数字掩模图案,可以实现整体尺寸为152.5 μm×114.2 μm,含特征尺度为150 nm(1像素),314 nm(2像素)和610 nm(4像素)的跨尺度复杂微纳结构图形(图3)。利用该无掩模光学投影纳米光刻技术,高效、便捷地实现了光波导、微机电系统和微流道等多种复杂跨尺度微纳结构的图案化。
无掩模光学投影超衍射纳米光刻技术将可见波长超快激光的非线性光学效应与DMD光场图案化技术结合,实现超越光学衍射限制的远场投影光刻,为跨尺度微纳复杂结构图案化提供了高效、便捷的新技术途径,有望在涉及电子、光学和生物等领域的微纳米器件的研究与开发中得到广泛应用,并实现定制化微纳结构与器件的低成本、高效率、批量制造。
相关研究工作得到科学技术部纳米科技重点专项、国家自然科学面上基金项目的支持。

图1 无掩模光学投影纳米光刻技术原理图
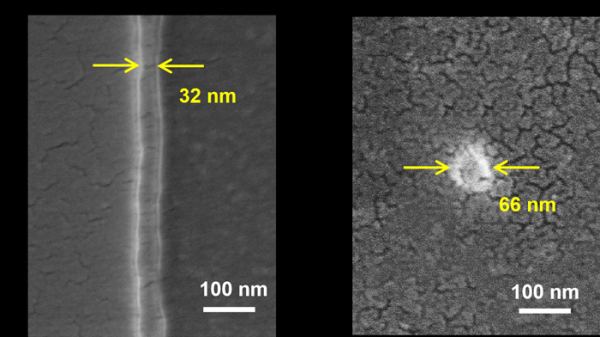
图2 超衍射纳米线与纳米点
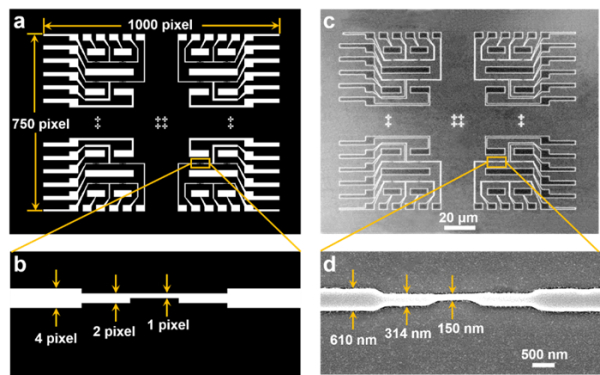
图3 跨尺度光刻图形
来源:中国科学院
原文链接:http://www.cas.cn/syky/202105/t20210527_4790139.shtml
版权声明:除非特别注明,本站所载内容来源于互联网、微信公众号等公开渠道,不代表本站观点,仅供参考、交流、公益传播之目的。转载的稿件版权归原作者或机构所有,如有侵权,请联系删除。
电话:(010)86409582
邮箱:kejie@scimall.org.cn

光刻技术首次绘出银纳米结构

新的DNA纳米结构:“DNA结”

DNA纳米光刻技术有望助力肿瘤精准诊断

氨基酸和多肽可制造出具有光学活性的金纳米粒子

合工大研发智能水凝胶,一分钟实现96%的自修复

人体细胞内存在“铁路”系统,能自动优化结构
第一届纳米纤维素材料国际研讨会在杭州召开




多元纳米结构功能薄膜的组合生长

光刻胶是极紫外光刻机突破3纳米的最大绊脚石,全新材料开发已箭在弦上

高熵合金的纳米力学与纳米结构的高熵合金