科技工作者之家
科技工作者之家APP是专注科技人才,知识分享与人才交流的服务平台。
科技工作者之家 2020-12-24
来源:高分子科学前沿
光刻胶是微电子技术中微细图形加工的关键材料之一,特别是近年来大规模和超大规模集成电路的发展,更是大大促进了光刻胶的研究开发和应用。日益严重的全球环境和能源危机已迫切推动了可持续材料的发展。大量的努力集中在开发新材料上,以取代基于冰,干冰,有机小分子和蛋白质等绿色资源的半导体工业中的化石抗蚀剂。然而,这样的抗蚀剂材料尚未满足高灵敏度,高分辨率,可靠的重复性以及与当前协议的良好兼容性的严格要求。
浙江大学伍广朋团队近期连发顶刊 在光刻胶领域取得系列进展。近期一篇发表在《Advanced Functional Materials 》名为“CO2‐Based Dual‐Tone Resists for Electron Beam Lithography”的研究成果为光刻胶领域增加新的思路。文章主要开发了具有高灵敏度的正性和负性二氧化碳基聚碳酸酯电子束光刻胶,具备高灵敏度(1.3/120×C cm-2),狭窄的临界尺寸(29/58 nm)和中等的线边缘粗糙度(4.6/26.7 nm)的性能。

[材料的合成和选择]
光刻胶的技术复杂,品种较多。根据其化学反应机理和显影原理,可分负性胶和正性胶两类。光照后形成不可溶物质的是负性胶;反之,对某些溶剂是不可溶的,经光照后变成可溶物质的即为正性胶。
作者首先通过二氧化碳和不同的的环氧化合物反应,生成不同的聚合物,其中包括,聚4-乙烯基环己烯碳酸酯(PVCHC),聚柠檬烯碳酸酯(PLC),聚丙烯碳酸酯(PPC),聚苯乙烯碳酸酯(PSC),聚环己烯碳酸酯(PCHC)和聚柠檬烯双碳酸酯(PLDC)。对于电子束抗蚀剂的利用,所有这些CO2-PC材料均通过传统的集成电路制造工艺进行了旋涂,预烘烤,电子束曝光和显影(如方案1b以PLC和PLDC为例)。

方案1 基于CO2的正性和负性抗蚀剂的合成路线和构图程序。
同时,作者对各种材料采用NRT(the normalized remaining thickness)方法总结各自的EBL(电子束光刻系统)性能。由表1可看出,PVCHC和PLC可作为负性胶,PPC,PSC,PCGC和PLDC可作为正性胶。最终考虑到它们的完全天然来源和可观的性能,分别选择PLC和PLDC作为模型系统的负抗蚀剂和正抗蚀剂,以评估显影剂和分子量对EBL性能的影响。
表1. CO2衍生的负性和正性抗蚀剂的理化和EBL性能
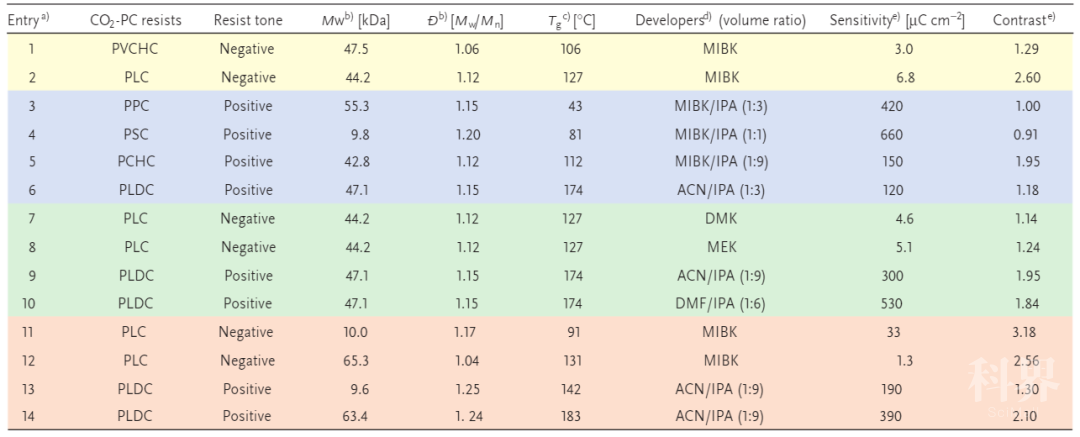
[工作原理]
要深入了解这些材料中的暴露机理,需要在EBL过程中监控化学反应(图1)。图1a,b中提出了负PLC和正PLDC抗蚀剂在电子束曝光下可能的反应途径。对于未曝光的PLDC膜,在图1c中观察到两个典型的羰基吸收峰,分别位于1756 cm-1(线性碳酸酯单元)和1815cm-1(环状碳酸酯单元)。当PLDC膜暴露于100至1000 µC cm-2的电子束时,两个羰基信号逐渐降低到可以忽略的水平,表明碳酸盐单元断裂成小分子。在加速电子的激发下,清楚地观察到了二氧化碳,二醇,环状碳酸酯的释放(图1d)。 基于已知的键能和环张力,在曝光过程中可能的断裂和降解途径如图1a中的虚线所示。
对于负PLC抗蚀剂,当曝光剂量从0增加到100 µC cm-2时,拉曼光谱(图1f)中C=C拉伸振动峰(1645 cm-1)的减小证实了双键的交联。与正性PLDC抗蚀剂相比,PLC主链上的羰基振动信号(1753 cm-1)没有显示出明显的下降(图1e),这表明在此条件下主链中的碳酸酯单元得到了很好的维护。在这种情况下,在暴露于高能电子下会产生自由基,此后发生不饱和双键的交联。根据C=C拉伸振动峰的积分面积,在10-100 µC cm-2的剂量下,分别有近15%和37%的双键发生了交联。双键的不完全反应可以归因于较高的双键密度和固态的PLC刚性骨架的有限运动。如纳米器件的成功制造,这种交联度足以维持用于纳米图案化的抗蚀剂薄膜的完整性。

图1 正电子和负电子抗蚀剂在电子束过程中的反应和特性。
[应用前景]
作者分别通过压花和凹版工艺制造了两个分别基于负PLC44和正PLDC47抗蚀剂的光子晶体器件。如图2的暗视野显微图像所示 鹰标志在白光的暗场照明下出现了深蓝色,靛蓝和绿色三种不同的颜色。反射光波长的区别是由于每个区域内部的方形晶格结构的晶格常数不同(分别为Λ = 500、600和700 nm)。负PLC44支柱的平均直径为0.44Λ,而正PLDC47支柱的平均直径为0.61Λ。 通过配备光谱仪的暗场显微镜确定的反射光谱,并显示了PL44在439、491和549 nm处,PLC44在433、492和569 nm处的反射光的峰值。结果表明,这些二氧化碳基正负电子束光刻胶有望用于制造功能性纳米器件。
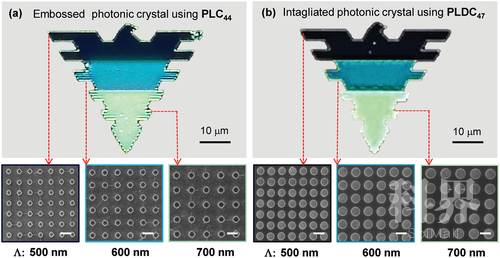
图2 使用负/正抗蚀剂分别压印和凹版化的光子晶体器件。
总言之,作者证明了通过将CO2与各种环氧化物共聚而制备的基于CO2的聚碳酸酯是用于电子束光刻的下一代可持续正负电子束抗蚀剂材料的有希望的候选者。并且与现有技术的良好兼容性,高灵敏度和高分辨率。
来源:Polymer-science 高分子科学前沿
原文链接:http://mp.weixin.qq.com/s?__biz=MzA5NjM5NzA5OA==&mid=2651765186&idx=7&sn=2eeb0645955cfeb3a49616081308f9fa
版权声明:除非特别注明,本站所载内容来源于互联网、微信公众号等公开渠道,不代表本站观点,仅供参考、交流、公益传播之目的。转载的稿件版权归原作者或机构所有,如有侵权,请联系删除。
电话:(010)86409582
邮箱:kejie@scimall.org.cn

新集成电路技术或可使太赫兹微芯片成为现实

突发!日本光刻胶要断供?

集成电路装备

中国集成电路发展引领者黄敞逝世

蜘蛛丝也可以用作光刻胶?
第二期“千人讲堂”开讲


集成电路设计

两款国产高端射频芯片发布,将推动我国5G布局
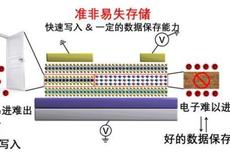
我国科学家开创第三类存储技术

打破国外垄断,我国拿下一项“制芯”关键技术